在半导体制造过程中,芯片测试是确保产品质量和性能的关键环节。它涉及到对每个制造出来的芯片进行细致入微的检测,以确保其满足设计和性能规格。芯片测试通常包括三个主要阶段:“晶圆测试”、“芯片测试”和“成品测试”,特别是前两个测试,尽管它们都在晶圆(Wafer)阶段进行,但二者的目的、测试对象、测试内容和作用是有显著不同的。本章节主要跟大家分享这三个测试阶段的详细介绍,以帮助有兴趣的朋友和同行更好地理解芯片测试的过程和重要性。
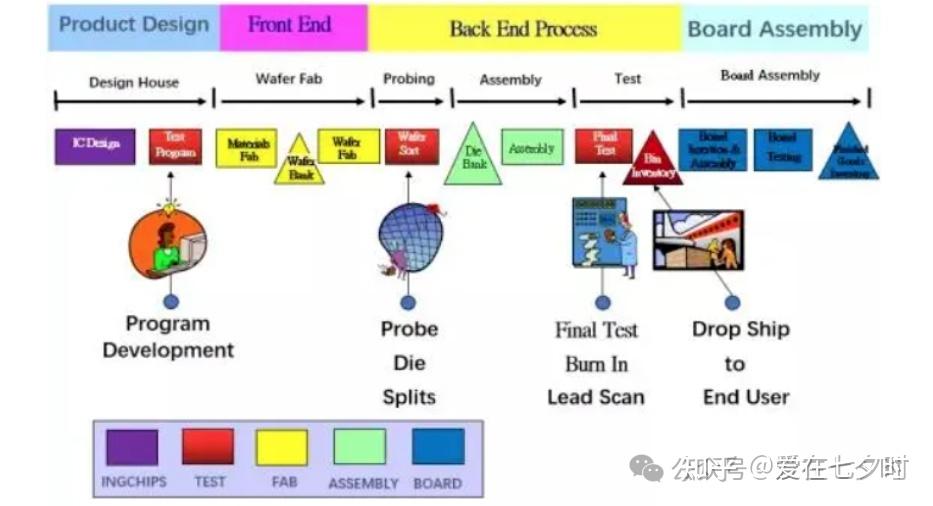
一、晶圆测试、芯片测试和成品测试的介绍
1、晶圆测试
晶圆测试,英文全称:Wafer Acceptance Test,简称:WAT。在晶圆加工过程中进行的测试,通过WAT,晶圆厂可以早期识别晶圆加工中的问题,如掺杂浓度不一致、光刻问题或蚀刻缺陷等,从而及时调整生产过程,避免大规模生产不良产品。WAT是在晶圆水平上进行的,目的是在芯片切割和封装之前发现并排除制程中产生的缺陷。在这个阶段,测试是通过探针卡连接到芯片上的测试点来进行的。探针卡上有成百上千的小针脚,这些针脚与芯片上的测试点相连接,将测试信号送入芯片并读出响应。

它主要是对专门的测试图形(test key)的测试,通过电参数来监控各步工艺是否正常和稳定;WAT(Wafer Acceptance Test)测试,也叫PCM(Process Control Monitoring),对Wafer 划片槽(Scribe Line)测试键(Test Key)的测试,通过电性参数来监控各步工艺是否正常和稳定。
WAT测试有问题,超过SPEC,一般对应Fab各个Module制程工艺或者机台Shift,例如Litho OVL异常,ETCH CD 偏小,PVD TK偏大等等。WAT有严重问题的Wafer会直接报废。
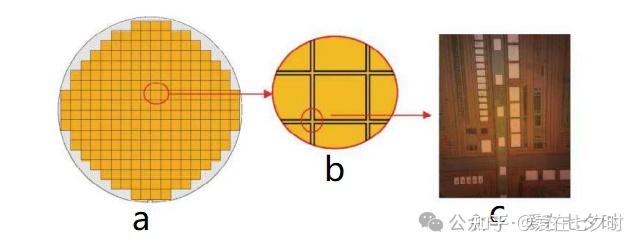
2、芯片测试
芯片测试,英文全称:Chip Probing,也可叫:Circuit Probing,简称:CP。在半导体制造结束后,芯片从晶圆分割并封装之前,使用探针卡接触晶圆上的芯片,进行电气测试以确保它们符合规格,一般包括vt(阈值电压),Rdson(导通电阻),BVdss(源漏击穿电压),Igss(栅源漏电流),Idss(漏源漏电流)等,不同类别的产品测试的参数也不同。

CP测试对象是针对整片wafer中的每一个Die,目的是确保整片wafer中的每一个Die都能基本满足器件的特征或者设计规格书,通常包括电压、电流、时序和功能的验证,如vt(阈值电压),Rdson(导通电阻),BVdss(源漏击穿电压),Igss(栅源漏电流),Idss(漏源漏电流)等,可以用来检测fab厂制造的工艺水平。可以更直接的知道Wafer的良率。
CP的难点是如何在最短的时间内挑出坏的die,修补die。
常用到的设备有测试机(Tester) 、探针台(Prober) 以及测试机与探针卡之间的接口(Mechanical lnterface)。一般测试机台的电压和功率不会很高。
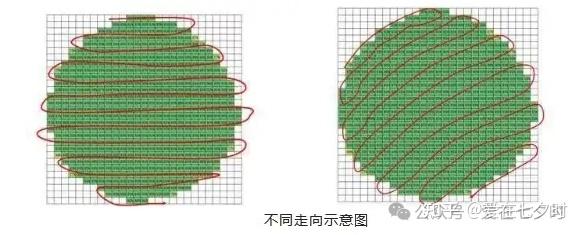
3、成品测试
成品测试,英文全称:Final Test,简称:FT。它是芯片出厂前的最后一道拦截。测试对象是针对封装好的chip,CP测试之后会进行封装,封装之后进行FT测试,也叫“终测”。可以用来检测封装厂的工艺水平。FT是把坏的chip挑出来;检验封装的良率。测试完这道工序就直接卖去做应用了。

FT测试一般分为两个步骤:
(1)自动测试设备 (ATE) ,这项测试设备一般小公司可能用不起,ATE试一般只需要几秒钟;
(2)系统级别测试SLT) ,这项测试是成品测试中的必须项,测试一般需要几个小时,但逻辑比较简单。
FT的难点是如何在最短的时间内保证出厂的Unit能够完成全部的功能。FT需要tester (ATE) + handler + socket。总之,这个测试目的是验证封装好的芯片在功能上是否完全符合设计规格,包括其性能、功耗、可靠性等。

二、晶圆测试、芯片测试和成品测试的区别
1、测试的内容不同
WAT测试通常包括参数测试和功能测试两部分。参数测试是检测芯片上的电气参数是否符合规格,如电压、电流、频率等。功能测试则是验证芯片的功能是否正确,确保其能够按照设计执行预定的操作。
CP测试通常包括数字和模拟电路的测试,以及混合信号电路的测试。测试内容广泛,从基本的电气参数测试到复杂的功能和性能测试都有。
FT测试通常包括环境测试、老化测试和应用特定的性能测试。环境测试是在模拟实际使用条件下进行的,如高温、低温、湿度等。老化测试是通过在加速应用条件下对芯片进行长时间运行,来模拟其在实际使用中的老化过程。应用特定的性能测试则是根据芯片的最终应用来设计的,确保其在特定应用中的性能。
2、测试的重要性不同
WAT测试能够在芯片进一步加工之前发现问题,这样可以避免在有缺陷的芯片上浪费更多的时间和资源。此外,通过分析晶圆测试的数据,工程师可以对制程进行优化,提高产量和降低成本。
CP测试可以确保每个芯片在离开工厂前都经过了严格的检测,满足产品的质量和性能要求。这对于确保最终产品的可靠性和性能至关重要。
FT测试能够确保芯片在实际使用条件下的性能和可靠性,是产品质量控制的最后一道防线。
3、测试阶段的不同
WAT测试和CP测试均是在晶圆上进行的,而FT测试则是对封装好的每颗芯片进行的。
CP测试是所有半导体制造工艺结束后进行的,WAT测试则是在特定半导体制造工艺结束后进行的,而FT测试是芯片封装完毕后进行的。
4、测试的频率不同
WAT测试一般是抽样进行,而CP测试是可抽测也可全测,但FT测试却一定是100%全测。
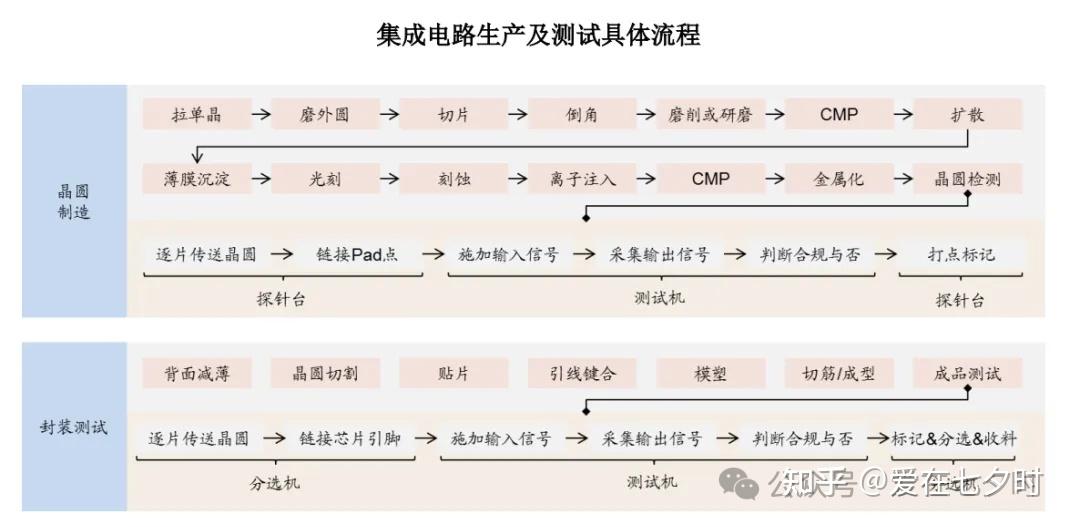
总结一下
半导体芯片测试是确保半导体产品质量和性能的关键环节。通过在不同生产阶段进行严格的测试,可以发现并排除缺陷,优化制程,提高产量和降低成本。WAT测试、CP测试和FT测试是芯片测试中的三个主要阶段,它们各自有不同的重点和内容,共同确保了芯片产品的高质量和高性能。随着半导体技术的不断进步和市场对高性能、高可靠性产品的不断需求,芯片测试的重要性将会越来越突出,其技术和方法也将不断发展和完善。
发表回复